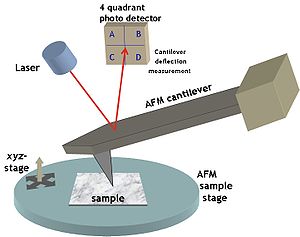
Atomu spēka mikroskopi (AFM) ir īpaša mikroskopu veida tehnika, kas ļauj attēlot virsmu topogrāfiju ar ļoti augstu izšķirtspēju — pat atomu līmenī. Tā līdzīgi kā skenējošais elektronu mikroskops (SEM) tiek izmantota, lai aplūkotu materiālu struktūru, taču AFM darbības princips un iespējas ir atšķirīgas, un to bieži pielieto nanotehnoloģijās un bioloģijā.
Darbības princips
AFM attēlo virsmas, izmantojot ļoti smalku uzgali (tuvu atomu izmēram), kas piestiprināts pie elastīgas kantilevera (konsoles) sijas. Uzgali pārvieto pāri parauga virsmai, un, mijiedarbojoties ar virsmas izciļņiem un bedrītēm, kantilevers noliecas vai vibrē. Šo novirzi parasti mēra ar lāzera staru, kas atstarots no kantilevera un reģistrēts pozicionējošā fotodiodē. Datu iegūšanas pamatā ir atgriezeniskā saite (feedback loop), kas uztur noteiktu spēku vai amplitūdu starp uzgali un virsmu, pārvietojot pjezoelektrisko skeneri (X, Y, Z) un reģistrējot Z-pozīciju, lai izveidotu topogrāfijas karti.
Uzgales un virsmas mijiedarbību nosaka spēki, piemēram, van der Waals spēki, elektrostatisks spēks, ķīmiskās saites vai šķidruma meniska spēki. AFM var gan pasīvi reģistrēt šos spēkus, gan aktīvi mērīt to atkarību no attāluma, veicot spēka–attāluma (force–distance) kravas—tas ļauj noteikt cietību, adhēziju un elastības parametrus.
AFM režīmi
Ir vairāki AFM darba režīmi, kas izvēlēti atkarībā no materiāla īpašībām un mērījuma mērķa. Galvenie režīmi ir:
- Kontakta režīms — uzgalis pastāvīgi skar virsmu un kantilevera nobīde tiek mērīta statiski. Tas nodrošina ātru attēlojumu, bet var bojāt mīkstus paraugus vai nodilumu uzgalei.
- Pieskaroties (tapping) vai intermitējošā kontaktā — kantilevers tiek uzkustināts rezonanses frekvencē un uzgalis periodiski pieskaras virsmai. Šis režīms samazina laterālo slodzi un ir piemērots mīkstiem vai lipīgiem bioloģiskiem paraugiem.
- Bezkontakta režīms — uzgalis nenonāk tiešā saskarē, bet reģistrē spēku izmaiņas, skanējot nedaudz virs virsmas (bieži izmanto vakumā). Tas samazina uzgaļa nolietojumu un gaitas izmaiņas, taču jutība pret dažiem spēkiem var atšķirties.
- Dinamiskie režīmi — izmanto kantilevera vibrāciju parametrus (amplitūdu, fāzi, rezonanses frekvenci) informācijas ieguvei par virsmas īpašībām.
- Speciālie modi — Force spectroscopy (spēka spektri), conductive AFM (elektriskās vadītspējas kartēšana), magnetic force microscopy (MFM), Kelvin probe force microscopy (KPFM), termiskā kartēšana u.c., kas paplašina AFM iespējas specifisku īpašību mērīšanai.
Komponentes un tehniskie parametri
- Kantilevers un uzgali — parasti izgatavoti no silīcija vai silīcija nitrīda; uzgaļa rādiuss (izšķirtspēja) un kantilevera stīvums (spring constant) ietekmē jutību un piemērotību dažādiem paraugiem.
- Detektors — lāzera–fotodiode sistēma katru malu novirzi pārvērš signālā; modernākās sistēmas var izmantot interferometriju vai kapacitātes mērījumus.
- Pjezoelektriskais skeneris — nodrošina precīzu X, Y, Z pozicionēšanu nanometru un pikometru mērogā.
- Resonanses frekvence — kantilevera rezonanses frekvence būtiski ietekmē darbības režīmus un ātrumu.
- Izšķirtspēja — atkarīga no uzgaļa rādiusa, vibrācijas trokšņa, stabilitātes un vides faktoriem; AFM var sasniegt atomu izšķirtspēju ideālos apstākļos.
Pielietojumi
AFM ir daudzfunkcionāls instruments ar plašu pielietojumu jomu:
- Nanotehnoloģijas: nanostruktūru raksturošana un manipulācija, virsmu raksturošana.
- Materiālzinātne: cietība, elastība, virsmas raupjums, plēvju biezums, nodiluma un mikrostrukturālo defektu analīze.
- Elektronika un pusvadītāji: vadošā AFM (C-AFM) vadītspējas kartēšana, lokālas elektriskās īpašības mērījumi.
- Bioloģija: dzīvu šūnu virsmu vizualizācija šķidrumā, olbaltumvielu, DNS un membrānu struktūru pētīšana bez nepieciešamības vakuumā.
- Ķīmija un virsmas zinātne: adhēzijas mērījumi, molekulāro saišu izturības noteikšana (force spectroscopy), ķīmiskās kartēšanas metodes.
- Magnētiskie materiāli: MFM ļauj kartēt magnetiskās domēnas un lokālās magnētiskās īpašības.
- Higiena un metrologija: precīza virsmu topogrāfija, kas nepieciešama ražošanas procesu kontrolei un kvalitātes nodrošināšanai.
Praktiskas piezīmes un ierobežojumi
- Paraugu sagatavošana: AFM parasti prasa gludu, stabilu parauga piestiprināšanu uz stikla vai metāla turētāja; šķidrumu mērījumiem nepieciešama speciāla šūna.
- Izšķirtspēja un mānīšanās: attēlos var parādīties mānīšanās efektus no nolietota uzgaļa, netīrumiem vai vibrācijām — regulāra tipa kontrole un kalibrācija ir svarīga.
- Atrašanās vide: AFM var darboties gaisā, šķidrumā vai vakuumā; izvēle ietekmē spēkus starp uzgali un virsmu un attēla kvalitāti.
- Ātrums: AFM parasti ir lēnāks par optiskajiem vai SEM attēlošanas veidiem, īpaši, ja nepieciešama ļoti augsta izšķirtspēja vai lieli lauki.
- Ierobežojumi: uzgali var nolietoties, mērījumi var ietekmēt mīkstus paraugus, un sarežģītas virsmas ar straujām reljefa izmaiņām var radīt artefaktus.
Noslēgumā AFM ir universāls un jutīgs instruments, kas sniedz ne tikai topogrāfisku informāciju, bet arī fizikas un ķīmijas īpašību datus lokālā mērogā. Pareiza režīma izvēle, uzgaļa tips un rūpīga kalibrācija ļauj optimizēt mērījumus dažādām lietojumprogrammām — no atomu izšķirtspējas attēliem līdz biomehāniskām spēku mērījumu serijām.